在日本科学技术振兴机构(JST)的战略性创造研究推进事业中,东京大学生产技术研究所的小林正治副教授等人成功开发了沟道采用8nm金属氧化物半导体IGZO(*1)的晶体管型铁电存储器(FeFET)。利用该技术,实现了能在亚阈值斜率为理想的60mV/dec、存储窗口(Memory Window)为0.5V以上的高迁移率下,以低电压工作的优异存储特性。
*1 由In-Ga-Zn-O构成的材料,在非晶状态下为半导体,迁移率为10~100cm2/Vs,目前主要用于显示器的驱动电路等。
栅极绝缘膜采用铁电二氧化铪(HfO2)的FeFET作为低功耗、大容量存储器件备受关注,不过沟道采用硅的器件结构会形成低介电常数界面层,由于界面层的电压降低,而且会发生电荷捕获,因此难以同时实现低电压和高可靠性。
为了抑制界面层的形成和电荷捕获的影响,在三维堆叠结构下也能获得大的数据读取电流,该研究提出了沟道采用金属氧化物半导体IGZO的铁电HfO2栅极绝缘膜FeFET。采用这种器件结构的话,能抑制IGZO与铁电HfO2之间形成低介电常数界面层。
此次的成果为实现低功耗、大容量的高速存储器件开辟了新的可能性,有望大幅提高物联网(IoT)边缘器件的能源效率、实现高级IoT网络以及完善基于大数据的社会服务。
相关研究成果已于2019年6月11日在“VLSI Technology Symposium 2019”上发表。
<研究背景与过程>
实现让所有的“物”和“事”都通过互联网连接的IoT社会,配备传感器和通信功能的传感器节点器件发挥着重要作用,据估算,今后将导入数万亿个以上的传感器节点。这些IoT器件的功耗必须要低,而且为了削减作为主要功耗的漏电流(电流泄露),需要使用能降低存储器待机电力的低功耗非易失性存储器。
栅极绝缘膜采用铁电体的晶体管型铁电存储器(FeFET)具有低功耗和大容量的特点。尤其是开发出了与集成电路制造工艺高度兼容、10nm以下的膜厚也显示出铁电性的铁电二氧化铪(HfO2)材料,受到了广泛关注。另外,还有望采用像闪存那样的三维堆叠结构,不仅是IoT器件,还有可能作为服务器用超大容量存储器使用。
不过,以往那些沟道采用硅的FeFET,栅极绝缘膜与硅沟道之间会形成低介电常数界面层,界面层的电压大幅降低,而且会通过界面层进行电荷捕获,难以同时实现低电压和高可靠性。另外,采用三维堆叠结构时,沟道需要使用迁移率较低的多晶硅,因此数据读取电流较小,访问时间可能会延迟。
<研究内容>
为了抑制界面层的形成和电荷捕获的影响,在三维堆叠结构下也能获得大的数据读取电流,本研究提出了沟道采用金属氧化物半导体IGZO的铁电HfO2栅极绝缘膜FeFET。采用这种器件结构的话,由于IGZO本身就是金属氧化膜,能抑制IGZO与铁电HfO2之间形成低介电常数界面层(图1)。
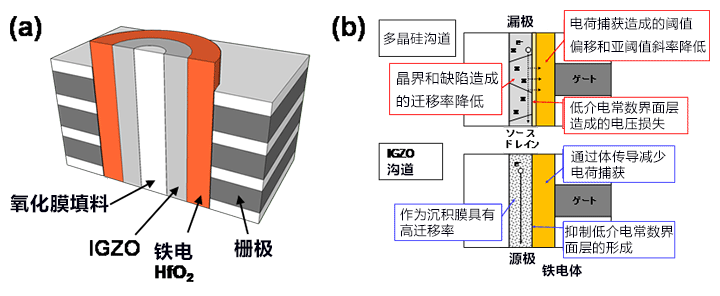
图1
(a)此次提出的三维堆叠型IGZO沟道铁电HfO2 FeFET的模式图
(b)采用多晶硅沟道和IGZO沟道的FeFET的特征比较。采用IGZO沟道能抑制界面层的形成和电荷捕获,可以实现高迁移率。
另外,通过使沟道采用N型掺杂IGZO,可作为无结晶体管工作,载流子通过体区(沟道中央部分)而非界面流动,因此能抑制载流子的电荷捕获。要想让无结晶体管常闭工作,即在栅极电压为零时不通电,需要控制阈值电压,因此将IGZO的膜厚减薄到了10nm以下。膜厚减至10nm以下的话,多晶硅的迁移率低于10cm2/Vs,但IGZO能保持10~100cm2/Vs的高迁移率。
在器件工艺的开发中,首先优化了IGZO的膜厚。研究小组制作了沟道采用IGZO、栅极绝缘膜采用二氧化硅(SiO2)的普通MOSFET,调查了亚阈值斜率和阈值电压对膜厚的依赖性,发现随着膜厚变薄,亚阈值斜率会减小,阈值也由负变为正(图2)。最终确认,8nm膜厚为最佳值,亚阈值斜率为理想的60mV/dec,阈值电压也变为正数,能实现常闭工作。
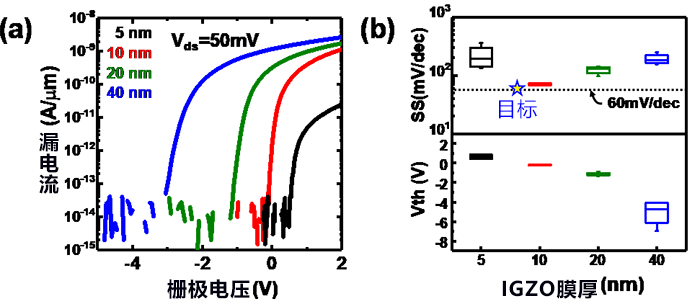
图2
(a)在开发FeFET的准备阶段,采用SiO2作为栅极绝缘膜制作的MOSFET的电流传输特性
(b)从(a)的数据中提取了亚阈值斜率和阈值电压。膜厚越薄,亚阈值斜率越陡,阈值电压也变为正数。本次研究以8nm为目标膜厚。
接下来调查了沟道采用IGZO时,栅极绝缘膜HfO2是否具有铁电性。研究小组以TiN为上部电极、以IGZO为下部电极,制作了添加Zr的HfO2(HfZrO2)电容器并进行了评测(图3)。从截面TEM图像中可以看出,没有形成界面层(图3(a)),另外,表示铁电体特性的剩余极化达到30μC/cn2,显示出非常高的值(图3(b)),表明能在IGZO沟道上形成铁电HfO2。
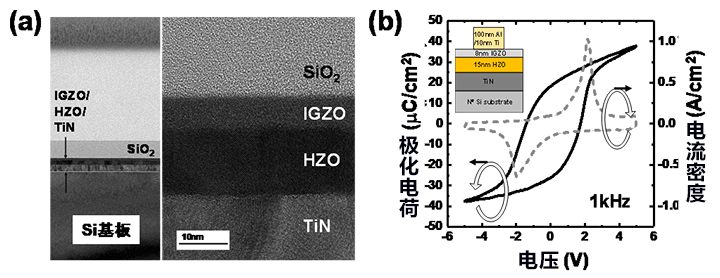
图3
(a)制作的TiN/HfZrO2/IGZO电容器的截面TEM图像
(b)电容器的极化电荷及电流密度特性。确认抑制了低介电常数界面层的形成,能在IGZO上形成铁电HfO2。
研究小组利用以上工艺要素,制作了沟道采用8nm膜厚IGZO的铁电HfO2栅极绝缘膜FeFET(图4)。电流传输特性显示出良好的特性,电流的开关比达到5位数以上(图4(a)),亚阈值斜率也与MOSFET获得的结果相同,实现了约60mV/dec的陡峭特性。另外,对场效应迁移率进行测量,获得了10cm2/Vs以上的值,比相同膜厚的多晶硅沟道高出50%以上(图4(b))。
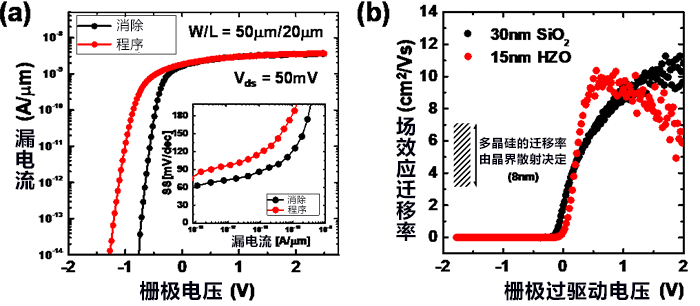
图4
(a)制作的IGZO沟道FeFET的电流传输特性
(b)场效应迁移率。亚阈值斜率为60mV/dec,几乎属于理想值,实现了具备0.5V以上的大存储窗口的FeFET。FeFET结构的场效应迁移率也获得10cm2/Vs以上的值,高于相同膜厚的多晶硅的迁移率。
通过将硅以外的新材料沟道用于存储器,FeFET实现了低电压、高可靠性和高迁移率,由此提示了开发存储器件的新方向,并开辟了进一步实现低功耗化、大容量化和高速化的可能性。
<未来展望>
为了验证沟道采用IGZO的FeFET概念,本次研究中使用了背栅型器件结构。今后采用顶栅型和三维堆叠型结构时,需要开发和评测堆叠型栅极结构。另外,为了提高保持特性,将调整铁电HfO2栅极绝缘膜的材料特性,为应用于IoT和存储类内存,将继续进行器件开发,计划实现1.8V的工作电压并提高改写速度,还将实现10年的数据保存、1012次的改写耐性以及1~10mA的读取电流等。
(日文发布全文)
文:JST客观日本编辑部